PCB焊盤上錫不良的原因有哪些?PCB焊盤上錫不良的原因分析
來源:www.firatast.com 作者:領卓PCBA 發布時間:2025-11-06 09:03:00 點擊數: 關鍵詞:PCB打樣
一站式PCBA加工廠家今天為大家講講PCB焊盤上錫不良的原因有哪些?PCB焊盤上錫不良的原因。PCB焊盤上錫不良是電子制造中常見的焊接缺陷,可能導致焊點強度不足、接觸不良甚至開路,其成因復雜且多因素耦合,可從以下六個核心維度進行系統分析:

PCB焊盤上錫不良的原因
一、PCB焊盤/基材問題
表面污染與氧化
污染源:PCB制造或儲存過程中暴露于空氣、濕氣、油脂、汗漬、灰塵、助焊劑殘留物或化學物質,導致焊盤表面形成隔離層,阻礙錫膏潤濕。
氧化層:銅質焊盤暴露于空氣中會形成氧化層,尤其當儲存時間過長或環境濕度過高時,氧化層增厚,降低可焊性。
表現:焊錫不潤濕焊盤,聚集呈球狀(縮錫),或部分鋪開但留有可見氧化層。
表面處理工藝缺陷
工藝選擇不當:如HASL(熱風整平)厚度不均、OSP(有機保焊膜)膜太薄或不均、ENIG(化學鎳金)出現黑鎳/黑盤、浸銀/浸錫鈍化。
工藝失效:表面處理層在儲存、運輸或組裝前處理(如清洗、烘烤、返工)中失效或損傷。
表現:OSP膜損壞的焊盤變暗或失去光亮度;ENIG黑鎳焊盤發黑;浸銀焊盤硫化變黑或產生微空洞。
設計缺陷
焊盤尺寸與形狀:焊盤過小或形狀不利于錫膏印刷/焊錫流動(如細長引腳的狹小焊盤),導致焊料無法充分覆蓋。
熱設計問題:焊盤與導熱引腳連接(Thermal Relief)設計不當,或直接連接大面積銅箔且無隔熱設計,導致焊盤吸熱過多,熔化不充分。
通孔設計:焊盤上存在大通孔,焊錫流入孔內,導致特定位置(如大接地焊盤)焊錫熔化不充分,潤濕不良。
阻焊層問題:阻焊層(綠油)印刷不良,污染或爬到焊盤上,或未完全固化,導致焊盤區域局部不沾錫。
二、元器件問題
引腳表面污染與氧化
污染源:元器件在制造、儲存或運輸過程中引腳表面氧化(如錫層氧化、銅合金引腳氧化)或被污染(如指紋、灰塵、塑封料溢出、硅脂、不明涂層)。
表現:焊錫在引腳上不潤濕,縮成球狀,或僅潤濕部分引腳。
引腳表面處理不當
處理工藝缺陷:引腳鍍層薄、粗糙、材料本身可焊性差,或超出有效期。
表現:同上。
引腳變形與結構問題
變形:器件(尤其是QFP、QFN、BGA等)引腳變形、彎曲,導致個別引腳不能與焊盤完全接觸。
結構設計不合理:端子結構設計導致焊接時元件翹起。
表現:同一器件上個別引腳虛焊、焊錫接觸不良。
三、錫膏問題
錫膏質量與匹配性
合金成分不匹配:如SnAgCu與SnPb合金成分差異,導致潤濕性不足。
顆粒度與金屬含量:錫膏顆粒度不均、金屬含量不足,影響熔融流動性。
助焊劑類型/活性:助焊劑類型與PCB焊盤表面處理、焊接工藝(回流曲線、波峰焊)不匹配,活性不足以去除氧化層。
過期與變質:錫膏超過保質期或儲存不當(未冷藏/回溫不足),導致助焊劑活性降低或變質,金屬顆粒氧化。
粘度異常:粘度過高或過低,影響印刷性和潤濕性。
表現:整體潤濕不良,活性不足以去除氧化層;潤濕性能差,塌落,冷焊,錫珠多,回流后殘留物異常多或發粘。
錫膏使用問題
攪拌不均勻:金屬與助焊劑分層,或過度攪拌導致升溫過快降低活性。
印刷后停留時間過長:溶劑揮發過多導致流動性下降。
表現:印刷形狀不良,回流后局部潤濕不良。
四、工藝過程問題
印刷工藝缺陷
刮刀參數不當:壓力、速度、角度不合適,導致印刷量不足、過量、拖尾、邊緣不平整、橋連。
脫模問題:脫模速度/距離不當,影響錫膏轉移。
鋼網問題:開口尺寸、形狀(梯形壁)、厚度設計不合理,導致錫膏量不足;鋼網張力不足或局部下陷;鋼網底面污染或開口堵塞。
PCB支撐問題:PCB下方支撐(頂針/支撐塊)高度或位置不合適,印刷時PCB變形,導致局部錫膏厚度不均。
表現:特定位置(如小間距、網板張力不均區域)錫膏轉移量不一致、少錫、拉尖。
貼片與插件問題
貼片精度偏差:偏移、角度、高度不當,導致元器件引腳未能準確落在對應焊盤的錫膏上。
貼片壓力不當:過大壓力壓塌錫膏或導致短路,過小壓力接觸不良或易移位。
插件問題:引腳彎曲、變形、未正確插入到底。
表現:焊接后一側(或多側)引腳不沾錫或虛焊。
回流焊問題
溫度曲線不當:預熱區溫度/時間不足(溶劑揮發不完全,升溫過快產生熱應力);預熱區過長/溫度過高(助焊劑提前消耗、錫膏表面結皮);回流區(液相線以上時間)不足、峰值溫度不足或過高;冷卻速率不當。
設備問題:設備老化或存在溫差,導致同一板子上不同位置(尤其大板、多層板)溫差大,局部溫度不足導致冷焊或潤濕不良。
傳送問題:傳送角度不合理(不利于焊錫爬升);傳送帶速度過快或過慢。
表現:助焊劑活性未充分發揮或提前耗盡,導致去氧化能力不足;焊錫未充分熔化;金屬間化合物(IMC)生長不良;潤濕角過大,焊點不飽滿。
波峰焊問題
噴涂問題:助焊劑噴涂量不足、不均勻、位置不對,導致覆蓋區域潤濕不良。
波峰參數不當:波峰高度或平整度差;預熱溫度不足。
表現:橋連、漏焊、陰影效應(元件阻擋焊錫)、不潤濕。
五、生產環境與設備問題
環境控制不當
溫濕度:濕度過高(>60% RH)會加劇焊盤氧化和助焊劑吸潮;溫度波動影響設備穩定性和錫膏粘度。
粉塵污染:空氣中粉塵附著于焊盤或元器件引腳,形成隔離層。
表現:加速氧化和污染過程,導致上錫不良。
設備維護不足
焊接設備:未定期維護,導致溫度控制不準確,焊接質量不穩定。
鋼網與印刷機:鋼網未清洗干凈、錫膏干涸殘留堵塞開孔;印刷機刮刀磨損。
貼片機:吸嘴堵塞/磨損,導致貼片精度下降。
回流爐:鏈速不穩定、爐膛污染。
表現:設備狀態不佳直接影響焊接質量。
六、特殊失效機制
陰極電遷移效應:沉金板在潮濕環境中離子遷移導致絕緣電阻下降。
錫須:純錫鍍層在應力下生長錫須,阻礙上錫。
黑盤現象:ENIG處理的焊盤鎳層被過度腐蝕(滲金過度),形成脆性且不易焊接的磷富集層。
二次回流問題:沉錫板在二次回流時,純錫層被消耗減薄,導致潤濕性差。
關于PCB焊盤上錫不良的原因有哪些?PCB焊盤上錫不良的原因的知識點,想要了解更多的,可關注領卓PCBA,如有需要了解更多PCBA打樣、PCBA代工、PCBA加工的相關技術知識,歡迎留言獲取!
熱門動態
-

如何優化PCBA打樣和量產價格?PCBA打樣價格與量產價格差異解析
時間:2025 瀏覽:18
-
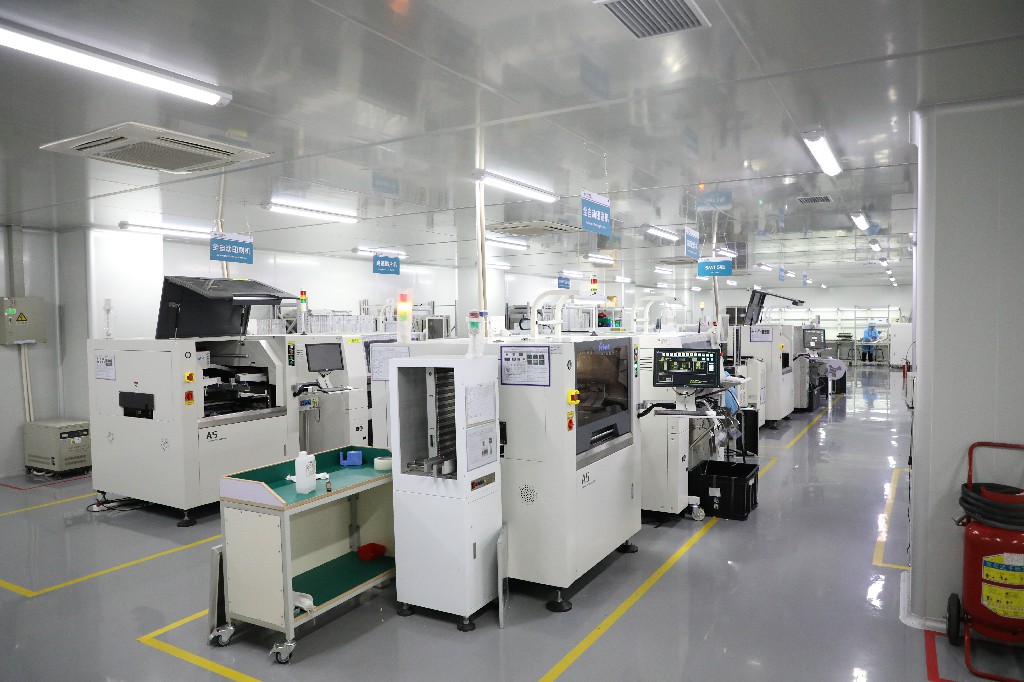
通訊模塊PCBA代工廠家
時間:2025 瀏覽:18
-

SMT貼片加工工藝標準有哪些規范要求?SMT貼片加工工藝標準技術規范
時間:2025 瀏覽:18
-

影響PCBA加工產品保存期限的因素有哪些?影響PCBA加工產品保存期限的因素
時間:2025 瀏覽:18
-

PCB上的小圓孔是什么?PCB小圓孔的種類及功能有哪些?
時間:2025 瀏覽:18
-

SMT貼片加工紅膠工藝有什么特點和優勢?SMT貼片加工紅膠工藝的特點和優勢
時間:2025 瀏覽:18
-

pcb制板中的無鉛噴錫與有鉛噴錫哪個好?無鉛噴錫與有鉛噴錫選擇
時間:2025 瀏覽:18
-

SMT貼片加工如何提高直通率?影響SMT貼片加工直通率的因素
時間:2025 瀏覽:18
-

SMT加工對PCB的要求有哪些?高品質、高效率SMT加工對PCB的要求
時間:2025 瀏覽:18
-
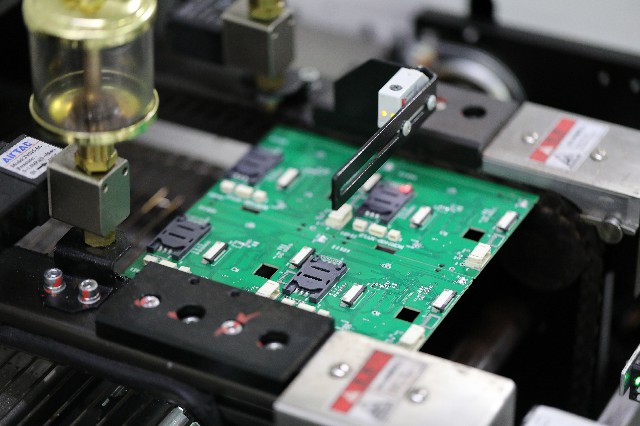
SMT貼片加工中重要的設備是什么?SMT流水線常見生產設備
時間:2025 瀏覽:18


 搜索
搜索
